PHASE 03
テスト
工程



ウェーハ製造工程
スライス・研磨・洗浄を経て半導体回路形成用の平坦で高精度な基板を作る工程です。





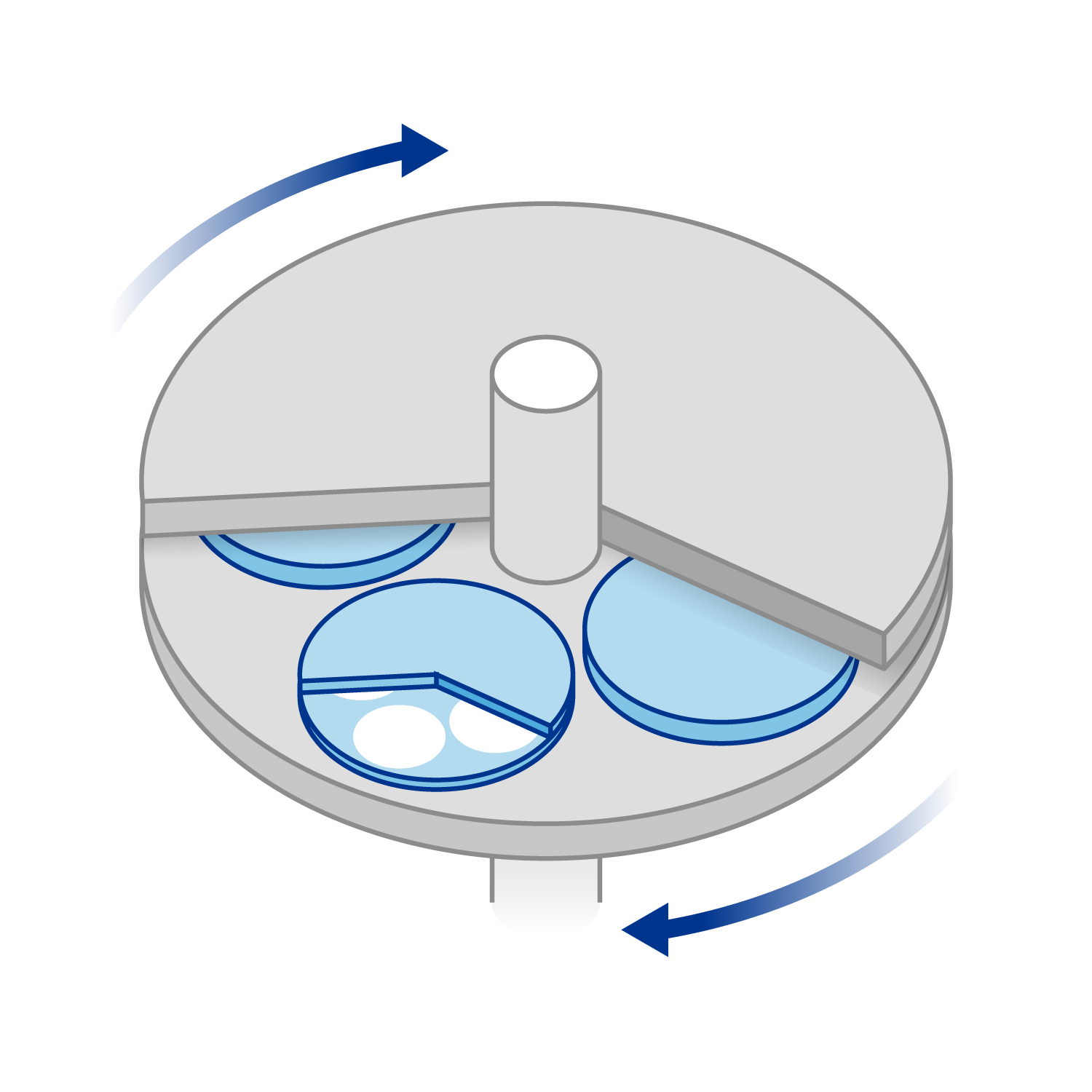



前工程
半導体回路を微細加工技術を用いて構築する工程です。










テスト工程
プローブ装置で測定し、不良品はマーキングまたはデータで管理します。


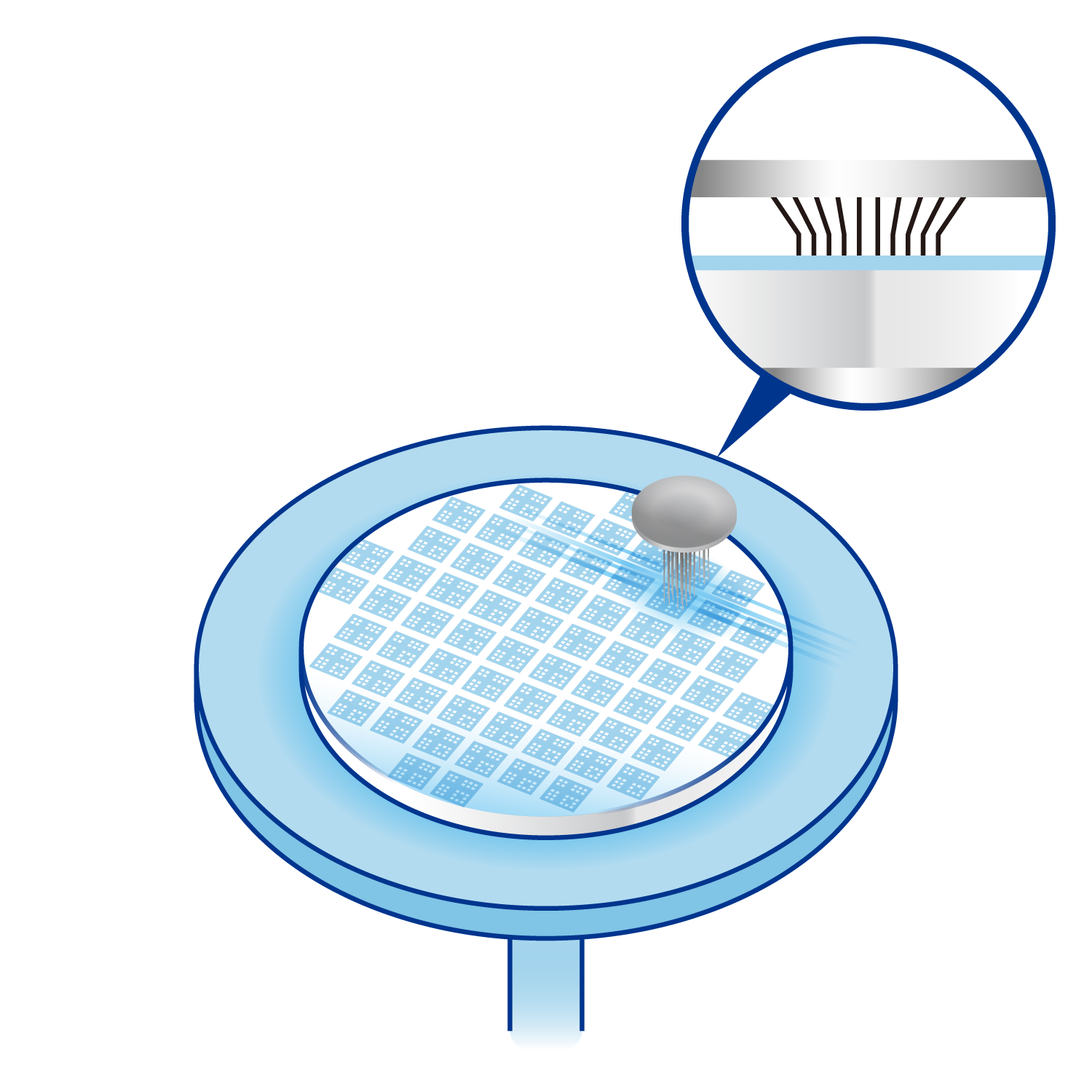
後工程
ダイシング、ダイボンディング、ワイヤボンディング、モールド、最終検査を経て出荷されます。














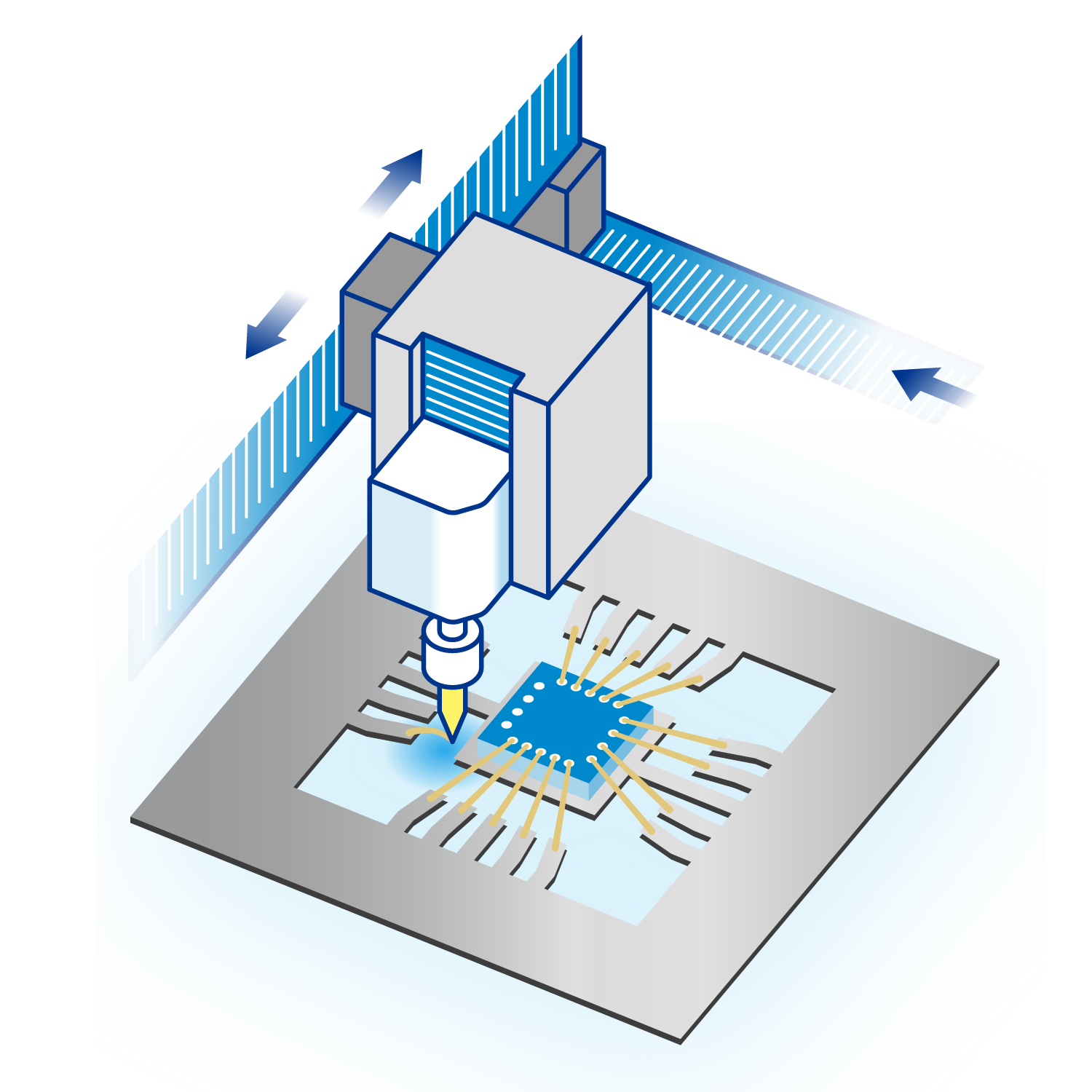
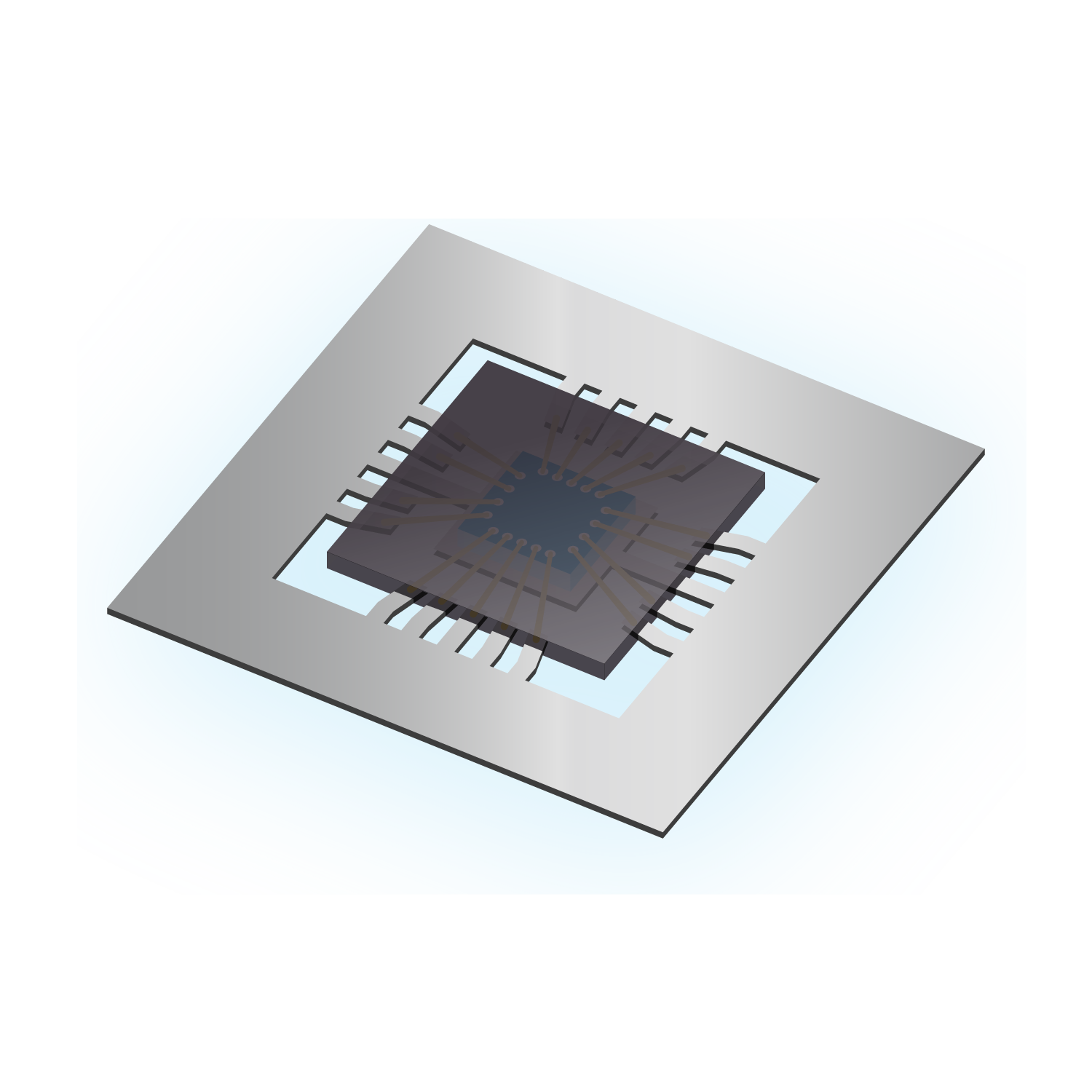





FAQ
よくある質問
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。
ここにテキストがはいりますこれはダミーテキストです
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。
ここにテキストがはいりますこれはダミーテキストです
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。
ここにテキストがはいりますこれはダミーテキストです
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。
ここにテキストがはいりますこれはダミーテキストです
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。
ここにテキストがはいりますこれはダミーテキストです
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。
ここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストですここにテキストがはいりますこれはダミーテキストです。